
服务热线 13823541376
深圳市谷易电子有限公司
联系电话:13823541376
联系人:兰小姐
邮箱:sales@goodesocket.com
主营产品:定制测试座、老化测试座、弹片微针模组、memory测试座、测试夹具、BGA老化测试、QFN老化测试、Flash闪存测试、编程烧录座
发表时间:2022-10-11 15:00:53浏览量:1407【小中大】
功率芯片SiC MOSFET测试方法?
SiC虽然材料有很多优势,但在突破技术瓶颈之前,已经经历了10多年,比如德国Infineon在2001年发布SiC二极管10年后才有SiCMOSFET的商业产品(Rohm:2011和Cree:2012)。国外半导体公司起步较早,产品、配套及相应的测试方法也比较完善。国内对SiCMOSFET研究方法,特别是可靠性检测方法,都比国外晚,爆发期集中在2018年左右。
由于SiC低势垒高度及材料SiC/SiO2高陷阱密度的界面,,阈值电压不稳定,影响设备的可靠性。阈值电压的不稳定性可分为两种情况:一种是界面陷阱引起的可恢复的松弛效应。松弛效应可视为界面陷阱在加正负格栅极电压时充放电的动态过程,而不是设备老化。

这一动态过程将影响阈值电压测量的准确性和基于阈值电压测量的温度测量的准确性;
另一个是由边界陷阱引起的长期不稳定温度(Biastemperatureinstability,BTI)。当栅极施加正偏压时,SiC/SiO2界面陷阱捕获电子,导致阈值电压正漂移(Positivebiastemperatureinstability,PBTI);当网极施加负偏压时,SiC/SiO接口陷阱发射电子导致阈值电压负漂移(Negativebiastemperatureinstability,NBTI)。温度偏置不稳定性是网格长期老化的表现,直接导致阈值电压漂移等相关参数的变化。
需要重新考虑上述阈值电压的不稳定性。此外,还需要考虑功率循环测试和老化参数监测。常用的通态电阻RDS,on(T)会受到设备老化的影响,如高栅极电压条件下阈值电压的漂移RDS,on退化,沟电阻为SiCMOSFET主要部件。同时,键合故障或表面金属化也会导致设备功率循环老化RDS,on该参数不适用于变化SiCMOSFET结温试验。
由于栅极的松弛效应,设备关闭后很短时间内无法形成稳定的阈值电压,导致温度测量偏差;另一方面,栅极氧层缺陷也导致老化过程中阈值电压严重降低,不仅影响温度测量的准确性,而且影响设备功率。
公认适用于目前SiCMOSFET装置结温测量的方法是利用装置二极管(bodydiode)温度特性在小电流下。通过给栅极正向电压进行设备功率循环测试(通常为15)V)打开MOS在正通道中,负载电流流入加热后,给格栅足够的负电压(一般小于-6V)以完全关闭MOS为了建立稳定的二极管电压,反向通道确保测量电流只流入体二极管。

栅极负压的选择对于准确测量结温和其他基于结温测量的测试非常重要。显示了XX的温度SiCMOSFET器件在-2V瞬态热阻抗曲线在格栅压力下测量。可以看出,瞬态热阻抗曲线在上升前先下降后出现错误结果。因此,在设备测试前,必须根据特定的设备和测试电路选择合适的栅极电压。虽然实际应用一般给定负压如-2V或-5V关闭就足够了。一些设备制造商已经将其关闭SiCMOSFET栅极负压降至-10V满足功率循环过程结温测量的要求。
进一步地,SiCMOSFET它挑战了测试电路和控制时间,开关延迟的选择也影响了设备温度测量的准确性。由于SiCMOSFET功率密度较高,材料热导率较高,使测量延迟范围内的温度冷却速度较快。最大温度测量误差需要注意。此外,该方法不能用于反并联二极管SiCMOSFET模块,这是因为反并联二极管将分离部分测量电流,无法形成稳定可靠的测试电压,迫切需要开发新的温度测试方法。
鉴于SiCMOSFET在不同的外部连接和栅极控制下,有三种不同的导通模式:正导模式:MOS模式,反向MOS模式和二极管模式[57]。在三种不同的模式下,不同的设备老化特性和不同的温度系数会导致不同的故障机制和功率循环寿命,如:正向MOS设备在模式下表现为正温度系数,加速设备的老化过程;反向MOS该模式为负温度系数,在一定程度上弥补和减缓了设备的老化过程。文献表明,在两种不同的模式下,设备的寿命差异可以达到2~5倍,正向MOS建议采用符合工况要求的模式。

而这也是与SiMOSFET特点不同,电动汽车标准不同LV在324中,允许使用体二极管加热进行功率循环,但是必须注意测试电流不一致对结果的影响。正如前面提到的,设备的饱和压降VCE/VDS功率循环用于表示器件键合线的老化状态,这取决于器件的通态电阻RDS,on(VDS=RDS,on*IL)。
对于SiCMOSFET,该参数必须受到阈值电压漂移和老化的影响,并且必须消除使测量受到影响的影响VDS只有表示键合线的老化状态,才能准确判断设备的故障。阈值电压的漂移与施加的电压极性、强度和时间有关。
当正负电压在短时间内累积效果一致时,可以在一定程度上积累“最小化”阈值电压漂移。SiCMOSFET功率循环寿命功率循环寿命一般为SiIGBT1/3[53],测试时间也很短。在功率循环测试中,将开启时间、正电压和关闭时间、反电压匹配,如正电压15V施加2s,反向电压-7.5V施加4s,阈值电压可以在一定程度上漂移VDS最小化变化。
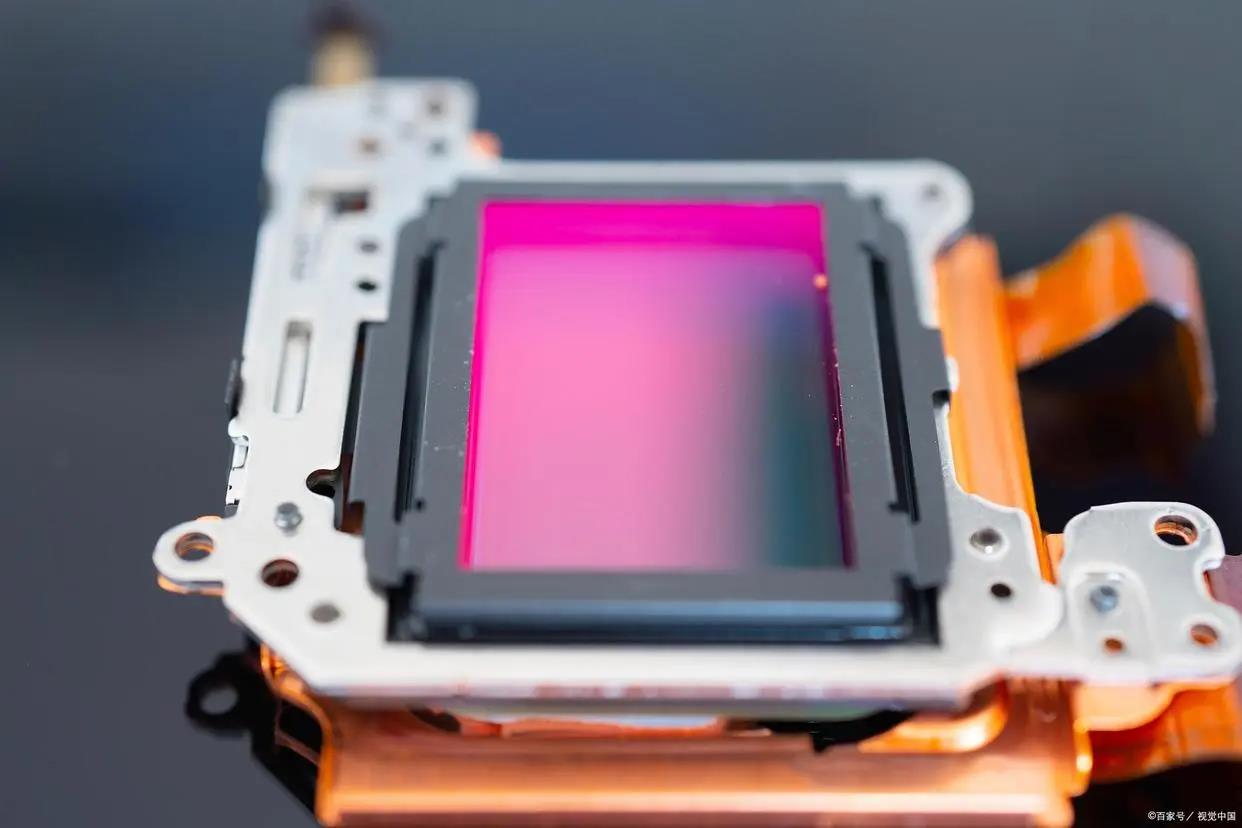
对于SiCMOSFET结温试验方法、功率循环试验模式法、功率循环试验模式和关键参数的影响。在谷易电子芯片测试座、SIC测试座、MOS管测试座、IGBT测试座、老化测试座、高温测试座的实际行业运用过程中,推荐几款反馈测试良率比较好的测试案列(仅供参考)
1、BGA6pin-0.4mm-1.285x0.885mm合金翻盖测试座
2、BGA112pin-0.5mm-5.5x5.5mm合金双扣旋钮导电胶测试座
3、QFN34pin-0.5mm-5x5mm合金翻盖测试座

 在线咨询
在线咨询



扫一扫关注官方微信
 13823541376
13823541376