
服务热线 13823541376
深圳市谷易电子有限公司
联系电话:13823541376
联系人:兰小姐
邮箱:sales@goodesocket.com
主营产品:定制测试座、老化测试座、弹片微针模组、memory测试座、测试夹具、BGA老化测试、QFN老化测试、Flash闪存测试、编程烧录座
发表时间:2025-11-10 10:24:41浏览量:337【小中大】
芯片测试贯穿制造全流程,其精度直接决定良率高低,而芯片测试座作为芯片与测试设备的唯一接口,是适配各类测试场景的关键载体。
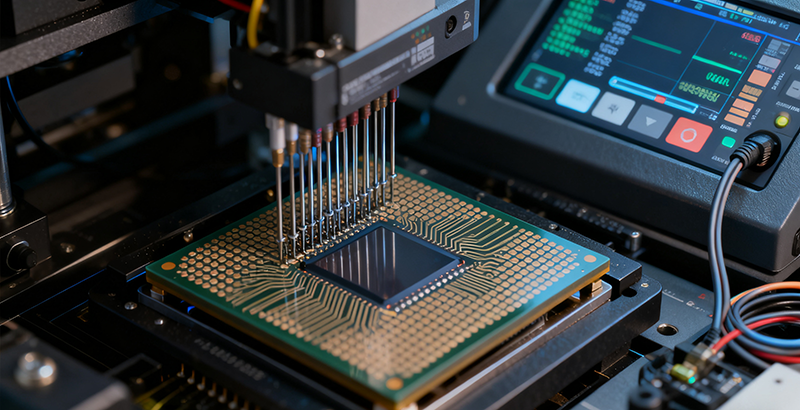
晶圆级测试(CP 测试)
晶圆切割前对裸片的 “前置筛查”,核心测试内容包括直流参数(漏电流、阈值电压等)与基础功能验证,需提前剔除短路、参数超标的不良裸片,避免封装成本浪费。此阶段裸片引脚间距仅 0.2-0.5mm、厚度数十微米,对测试座的高精度接触与低损伤性要求严苛。
成品级测试(FT 测试)
封装成型后的 “终检关卡”,涵盖三大维度测试:
功能测试:验证逻辑功能与协议兼容性(如 DDR、PCIe 接口),故障覆盖率需≥95%;
性能测试:监测高频信号传输(5G 芯片需 30GHz 以上带宽)、极限功耗等动态参数;
可靠性测试:模拟极端工况验证,如高温(125℃)、低温(-55℃)、高压(700V AC)及 8kV ESD 防护测试。
不同应用场景对测试环境提出差异化要求:车规芯片需通过 - 65℃~150℃温度循环测试,5G 芯片需保障 35GHz 高频信号完整性,工业芯片需耐受 - 40℃~125℃宽温域与振动环境。测试座需同时满足信号传输精准性、环境耐受性与机械稳定性,才能避免测试误差导致的良率损耗。

谷易电子针对 CP/FT 不同阶段的需求,通过精准技术设计构建测试可靠性,从源头降低不良品误判与漏检风险。
微间距精准接触技术
采用铍铜镀金探针设计,支持最小 0.15mm 引脚间距,定位精度达 ±0.005mm,接触阻抗≤25mΩ(远优于行业平均 50mΩ),可精准捕捉微伏级电压与微安级电流信号,避免因接触偏移导致的 “良品误判”。探针头部圆弧打磨处理使接触压力控制在 5-10g,杜绝裸片划伤。
批量测试效率提升
模块化设计支持 8-12 颗裸片同步测试,配合 ATE 系统实现每小时 3000 + 颗检测效率,筛选准确率达 99.98%。据行业数据,此方案可帮助封测厂降低 30% 以上无效封装成本 —— 单颗不良裸片流入封装环节将造成 20 倍成本浪费。
极端环境兼容设计
采用 PEI 耐高温壳体与屏蔽式结构,耐温范围达 - 60℃~180℃,可直接嵌入高温老化炉完成 1000 小时 HTOL 测试(满足车规 AEC-Q100 标准)。在高频场景中,支持 35GHz 带宽信号传输,衰减<2dB,优于行业 3dB 标准,保障 5G/WiFi 6 芯片测试准确性。
高可靠性与多封装适配
镀金触点 + 弹簧式结构使机械寿命>10 万次(行业平均仅 5 万次),绝缘阻抗≥1500MΩ@500V DC,耐电压达 800V AC/1min,满足 IEC 61010-1 安全标准。通过可更换适配卡座,兼容 BGA、QFN、SiP 等主流封装,切换时间<5 分钟,提升产线柔性。
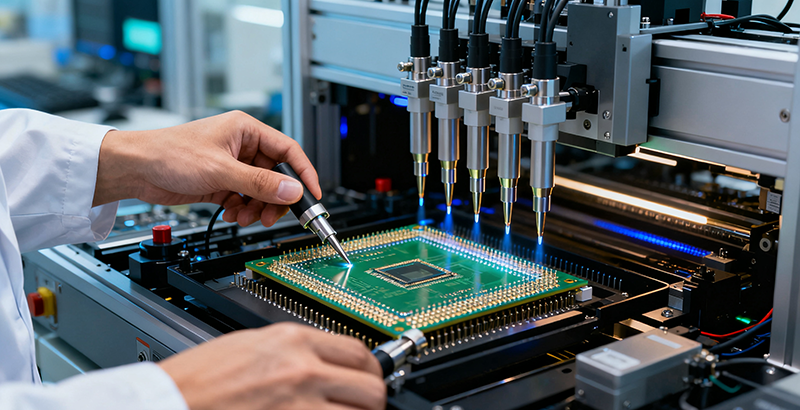
降低无效成本损耗:CP 阶段的高精度筛选减少不良裸片封装浪费,FT 阶段的稳定测试避免不良成品流入市场 —— 谷易测试座可将成品不良率控制在 1DPPM 以下,满足车规级准入要求。
提升测试数据可信度:通过低阻抗接触、抗干扰结构与环境适配设计,使测试误差率从传统的 8% 降至 2% 以下,确保参数测量与功能验证结果可靠,减少因测试设备导致的良率误判。
适配产业升级需求:从消费电子低功耗测试到车规高频测试,谷易测试座的模块化与定制化能力,可响应不同芯片品类的测试需求,为封测厂提供 “精度 - 效率 - 成本” 平衡的良率优化方案。

 在线咨询
在线咨询



扫一扫关注官方微信
 13823541376
13823541376